因为专业
所以领先
得益于AI对算力的极致追求,3D集成技术已成为半导体行业延续摩尔定律的关键路径。它通过将芯片从平面“拼图”变为立体“高楼”,实现了性能的跨越式提升。

下面这个表格梳理了当前三大半导体巨头在3D集成领域的技术布局与特点,可以帮你快速建立起整体认知。
| 厂商 | 核心技术 | 战略重点与路径 | 互连技术进展 | 散热策略 |
| 台积电 (TSMC) | CoWoS (2.5D), SoIC (3D) | 将先进封装视为与晶体管技术并行的核心,提供系统级集成方案 | 超键合(Super Bonding)技术,互连间距从9μm向5μm及以下演进 | 导热通孔(TSV),协同EDA工具进行热建模与仿真 |
| 英特尔 (Intel) | Foveros (3D), EMIB (2.5D) | 发挥IDM 2.0垂直整合优势,强调系统级平台整合,如逻辑层与SRAM缓存层堆叠 | 高密度堆叠技术,结合EMIB实现横向连接优化 | 导热通孔(TSV),并探索蒸汽帽等方案 |
| 三星 (Samsung) | X-Cube (3D), 3.5D集成 | 利用自身在HBM内存领域的优势,强调逻辑-内存协同设计 | 推动LCOE逻辑堆叠方案,计划在2027年实现更先进节点堆叠 | 依赖在内存堆叠和热管理领域的深厚积累 |
要实现表格中的各种架构,背后是多项关键工艺的精密配合,也面临着严峻挑战。
互连技术:这是3D集成的核心。混合键合 已成为主流方向,它像搭乐高一样,通过微米级的铜-铜直接键合实现芯片间垂直互连,能大幅提升I/O密度和能效。硅通孔 则是连接不同芯片层的“垂直高速公路”,其密度和工艺直接影响信号传输效率和热传导。
散热挑战:散热是3D集成最大的挑战之一,被称为“最后一道关卡”。芯片堆叠导致热量高度集中,业界正在探索从材料到系统的多维度解决方案,包括导热通孔、蒸汽帽(利用相变散热),甚至微流体冷却(在芯片内嵌入微细管道输送冷却液)等创新技术。
供电与信号完整性:随着晶体管密度飙升,传统的正面供电网络会挤占信号布线空间。背面供电 技术将电源线“挪到”芯片背面,让信号线走得更顺畅,是未来高性能芯片的关键技术,英特尔、台积电和三星都已将其纳入路线图。此外,在2.5D/3D封装中,静电放电保护 和信号完整性 也面临新挑战,研究趋势是将保护结构从芯片内部转移到硅中介层或封装层面,以节省面积、提升性能。
除了上述主流技术,一些前沿研究正在为3D集成开辟新的可能性。
微纳3D打印:这项技术正从实验室走向产业端,在封装原型开发和特定功能部件制造上展现出独特价值。它无需昂贵的掩膜版,就能快速制造出高精度的中介层、天线等复杂结构,极大加速了研发迭代周期。
新材料与异构集成:以氮化镓 为代表的第三代半导体材料与硅基CMOS驱动芯片的3D异质混合集成,为超越传统摩尔定律提供了新路径。这种技术能在单一芯片上融合不同材料的性能优势,实现更强大的功能。
更前沿的探索:麻省理工学院的研究人员正在探索利用嵌段共聚物的定向自组装来制造3D互连结构,这有望为纳米尺度的3D制造提供全新方法。同时,共封装光学 技术也被视为未来解决芯片间超高带宽数据传输入口瓶颈的终极方案之一。
总的来说,3D集成技术的发展已从单点的封装技术竞赛,转变为覆盖材料、设计工具、制造工艺和系统架构的全生态系统竞争。未来的赢家,必然是那些能够率先打通从设计、制造到封装、测试整个垂直协同链条的玩家。
希望这份分析能帮助你全面把握3D集成工艺的发展脉络。
水基清洗的工艺和设备配置选择对清洗精密器件尤其重要,一旦选定,就会作为一个长期的使用和运行方式。水基清洗剂必须满足清洗、漂洗、干燥的全工艺流程。
污染物有多种,可归纳为离子型和非离子型两大类。离子型污染物接触到环境中的湿气,通电后发生电化学迁移,形成树枝状结构体,造成低电阻通路,破坏了电路板功能。非离子型污染物可穿透PC B 的绝缘层,在PCB板表层下生长枝晶。除了离子型和非离子型污染物,还有粒状污染物,例如焊料球、焊料槽内的浮点、灰尘、尘埃等,这些污染物会导致焊点质量降低、焊接时焊点拉尖、产生气孔、短路等等多种不良现象。
这么多污染物,到底哪些才是最备受关注的呢?助焊剂或锡膏普遍应用于回流焊和波峰焊工艺中,它们主要由溶剂、润湿剂、树脂、缓蚀剂和活化剂等多种成分,焊后必然存在热改性生成物,这些物质在所有污染物中的占据主导,从产品失效情况来而言,焊后残余物是影响产品质量最主要的影响因素,离子型残留物易引起电迁移使绝缘电阻下降,松香树脂残留物易吸附灰尘或杂质引发接触电阻增大,严重者导致开路失效,因此焊后必须进行严格的清洗,才能保障电路板的质量。
合明科技研发的水基清洗剂配合合适的清洗工艺能为芯片封装前提供洁净的界面条件。
合明科技运用自身原创的产品技术,满足芯片封装工艺制程清洗的高难度技术要求,打破国外厂商在行业中的垄断地位,为芯片封装材料全面国产自主提供强有力的支持。
推荐使用合明科技水基清洗剂产品。
合明科技致力于为SMT电子表面贴装清洗、功率电子器件清洗及先进封装清洗提供高品质、高技术、高价值的产品和服务。合明科技 (13691709838)Unibright 是一家集研发、生产、销售为一体的国家高新技术、专精特新企业,具有二十多年的水基清洗工艺解决方案服务经验,掌握电子制程环保水基清洗核心技术。水基技术产品覆盖从半导体芯片封测到 PCBA 组件终端的清洗应用。是IPC-CH-65B CN《清洗指导》标准的单位。合明科技全系列产品均为自主研发,具有深厚的技术开发能力,拥有五十多项知识产权、专利,是国内为数不多拥有完整的电子制程清洗产品链的公司。合明科技致力成为芯片、电子精密清洗剂的领先者。以国内自有品牌,以完善的服务体系,高效的经营管理机制、雄厚的技术研发实力和产品价格优势,为国内企业、机构提供更好的技术服务和更优质的产品。合明科技的定位不仅是精湛技术产品的提供商,另外更具价值的是能为客户提供可行的材料、工艺、设备综合解决方案,为客户解决各类高端精密电子、芯片封装制程清洗中的难题,理顺工艺,提高良率,成为客户可靠的帮手。
合明科技凭借精湛的产品技术水平受邀成为国际电子工业连接协会技术组主席单位,编写全球首部中文版《清洗指导》IPC标准(标准编号:IPC-CH-65B CN)(“Guidelines for Cleaning of Printed Boards and Assemblies”),IPC标准是全球电子行业优先选用标准,是集成电路材料产业技术创新联盟会员成员。
主营产品包括:集成电路与先进封装清洗材料、电子焊接助焊剂、电子环保清洗设备、电子辅料等。
半导体技术应用节点:FlipChip ;2D/2.5D/3D堆叠集成;COB绑定前清洗;晶圆级封装;高密度SIP焊后清洗;功率电子清洗。


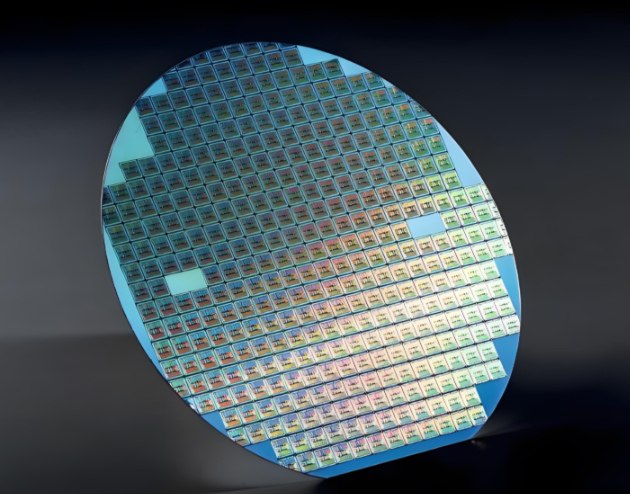


![[x]](/template/default/picture/closeimgfz1.svg)